隨著ChatGPT、DeepSeek、Gemini等大模型的橫空出世,全球算力需求呈現指數級爆發。當所有人都在討論GPU芯片的緊缺時,硬件工程師們卻面臨著另一個嚴峻的底層挑戰:如何承載如此驚人的算力密度?
答案藏在那些不起眼的綠色板卡中。AI服務器對信號傳輸速率、電源完整性及散熱的極致要求,正在倒逼PCB產業進行一場“層數”與“密度”的革命。高多層PCB與HDI技術,已成為AI硬件研發中不可或缺的“隱形基石”。

一、 拆解AI服務器:算力怪獸的“血管”與“骨架”
與普通服務器不同,AI服務器的硬件架構極其復雜。根據國金證券的深度拆解,一臺頂級AI服務器的PCB主要分為三大核心:GPU板組、CPU母板組和配件 。
以英偉達DGX A100為例,它大體上可以分為五個硬件板塊:
1.風扇模組,DGX A100 的風扇模組由 8 個風扇組成,這一搭配與傳統服務器 8U 規格的基本一致;
2.硬盤,風扇模組板塊的下方擺放了硬盤和前控制臺板(控制與外接設備的信號傳輸),DGX A100 配備了 8 個 3.84TB 的硬盤,合計內部存儲 30TB;
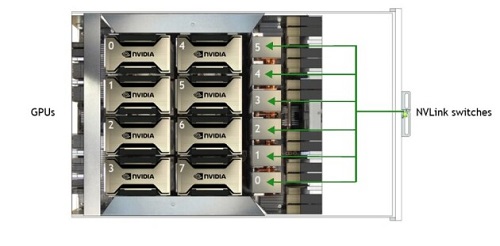
3.GPU 板組,后部是整個 AI 服務器的關鍵組件組裝區域,最核心的板塊就是 GPU 板組,這也是 AI 服務器區別與普通服務器的關鍵,從 DGX A100 的架構來看,GPU 板組主要包含 GPU 組件、模組板、NVSwitch 三塊,這三塊都會涉及到不同類型的 PCB 產品;

4.CPU 母板組,這一部分是所有服務器的核心部件(包括普通服務器和 AI 服務器),其中包含 CPU 母板、系統內存、網卡、PCIE Switch 等部件,CPU 母板、系統內存、網卡是主要涉及到 PCB 用量的部分;
5.電源模組,DGX A100 后部的下方還配有 6 組電源,電源內部會涉及到厚銅 PCB 板的使用。
從價值量來說,一臺普通服務器的PCB單機價值量約為2425元,而一臺DGX A100的PCB價值量高達15321元,提升了532% 。這其中,80%的價值增量來自GPU板組 。
GPU模組板作為承載8顆GPU的超級底座,需要極高的層數來布線。在DGX A100中,GPU 模組板面積約0.3平方米,通常需要26層通孔板,且必須使用Ultra Low Loss(超低損耗)等級材料 。
GPU 加速卡是承載GPU芯片的核心單元。在DGX H100中,OAM甚至采用了5階HDI工藝,以滿足芯片間極高密度的互連需求 。
而CPU主板方面,即使是通用的CPU主板,在PCIe 5.0/6.0總線標準下,也普遍采用10-12層以上的設計,且單價大幅提升 。
二、高多層設計和制造的技術痛點
對硬件研發工程師而言,設計一款AI類的高多層板,意味著要翻越幾座大山。即使順利完成設計,制造過程也面臨諸多挑戰。這里試舉兩例:
1.極其嚴苛的信號完整性
在AI服務器中,GPU互連和PCle總線速度極快。為了減少信號反射,高多層PCB制造過程中必須使用背鉆工藝。所謂背鉆是指在多層板的一面進行不貫穿的鉆孔加工,去除不需要的內層電氣互連。它可以消除stub對信號完整性的影響度,確保高頻信號的完整性和阻抗連續性。以嘉立創為例,針對高多層PCB推出了背鉆工藝,支持4-64層高多層PCB。此外,還需要嚴格控制阻抗(通常誤差要求在±10%甚至更低)。

2.超高縱橫比的制造難度
為了支撐大電流和散熱,AI服務器的PCB板厚通常在3.0mm-5.0mm之間。這就導致鉆孔的縱橫比極高。當機械鉆孔縱橫比達20:1(孔深/孔徑)時,板厚在5.0mm時,最新孔徑僅為0.25mm。這對過孔電鍍是一個嚴峻的挑戰。
三.研發破局:嘉立創如何以“高多層+HDI”一站式擊穿技術壁壘
對于硬件研發工程師而言,設計一款AI類的高多層板,往往意味著要面對“做不了、做得慢、做得貴”的三重困境。嘉立創憑借數字化智造能力,將高多層PCB和HDI板打造成了標準化服務,為工程師提供了新的解決方案。
1.突破層數與交期瓶頸:從“按月等”到“按周拿”
AI服務器主板動輒20層以上,且板厚常在3.0mm-5.0mm之間 。傳統工廠面對這種超高層訂單,往往需要排單生產,樣板交期長達3-4周,嚴重拖慢研發迭代速度。

嘉立創現今的制造能力覆蓋1-64層,不僅能滿足常規AI板卡需求,更能承接航空航天等極端復雜的電路集成設計。并且,通過自動化產線和數字化流程,嘉立創將高多層樣板交期壓縮至10-15天,比行業平均水平快1倍,幫助研發團隊搶占市場先機。
2.攻克高密度互連難題:HDI與背鉆技術的普及化
AI芯片(如GPU、Switch芯片)引腳密度極高,必須使用HDI(高密度互連)工藝。但高階HDI工藝復雜,激光鉆孔精度難控制,且高速信號需要的背鉆工藝容易產生Stub殘留,影響信號完整性 。
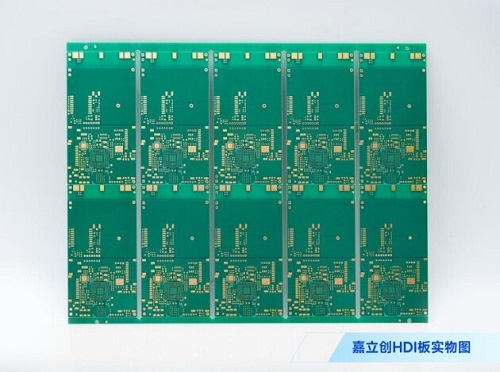
嘉立創支持1階到3階的HDI盲埋孔設計,配備高精度激光鉆孔(最小孔徑0.075mm)和填孔電鍍工藝,完美適配高密度BGA封裝 。同時,提供高精度的背鉆工藝,有效減少信號反射。并且,采用LDI激光直接成像技術,層間對準度可達5mil(針對超高層)。
3.重塑成本:讓高多層打樣不再昂貴
高多層板因良率低、材料貴,打樣成本極高。且一旦發生板翹或開短路,將導致昂貴的AI芯片報廢。
嘉立創高多層板全部采用生益 FR-4 S1000-2M (Tg170) 等高頻高速板材,確保高耐熱性和低膨脹系數,適配AI服務器的高溫工況 。并且,得益于高效率,高多層打樣成本比同行低50%左右,極大降低了研發試錯門檻 。
寫在最后
AI算力的競爭,歸根結底是硬件工程的競爭。當您在設計下一代AI服務器、加速卡或高性能計算單元時,不需要再為PCB的層數限制或漫長的交期而焦慮。嘉立創高多層及HDI服務,正以工業級的品質、互聯網的速度和極具競爭力的價格,成為您硬件創新路上的堅實后盾。


